2. 深圳市美信咨询有限公司,广东 深圳 518055
2. Meixin Consulting Co., Ltd., Shenzhen 518055, China
显微结构、取向和成分分布是决定结晶材料各种性能的关键因素[1]。在扫描电镜中,扫描电镜图像可以获得显微结构和形貌信息,能谱仪可以获得成分信息,而电子背散射技术(Electron Backscatter Diffraction,以下简称EBSD)可以获得结构和取向信息。虽然EBSD技术商品化较晚,在上世纪九十年代初才初露头角[2],但是它发展迅速[3-4]。目前,EBSD在材料研究中的应用已十分广泛,其应用范围包括金属、半导体、矿物和陶瓷材料等领域,是研究结晶材料中成分、组织、工艺与性能关系的重要工具。与X射线衍射(获取宏观的统计信息)和透射电镜(获取极微小区域信息)相比,EBSD可以在微米到毫米范围内提供物相的类型和分布、晶粒大小、形状和缺陷、晶界类型、局部晶体取向及择优取向等大量有价值的信息[5],弥补了微米尺度结构和取向表征的空缺。
随着场发射电镜的进展和应用领域的增加,EBSD技术也出现了很多新进展。首先,由于纳米材料的发展,对于更高空间分辨率的要求越发迫切,透射菊池衍射(Transmission Kikuchi Diffraction,TKD)是一个提高空间分辨率的方向。在其基础上又有新的进展,比如同轴TKD技术[6-9]; 其次,对处理速度的追求,通过探测器的改进可以实现更快的采集速度, 除了提升效率,还可以减轻表面污染、荷电和样品漂移。本文首先简介EBSD表征技术的基础知识,然后再介绍上述EBSD技术领域的重大进展。
1 基础知识 1.1 菊池花样和取向图EBSD在扫描电镜中使用菊池衍射。它采集的菊池花样由许多菊池带组成。菊池带的形成经历了两个过程[10]:首先,入射电子与晶体相互作用产生非相干的准弹性背散射电子;其次,准弹性背散射电子发生相干衍射,即各个方向的准弹性背散射电子入射到一族平行的晶面,满足布拉格条件就可能产生衍射,投影到探测器的屏幕上即可得到近似平行的菊池带。在菊池衍射中,信号源犹如在样品内部,将衍射面投影到磷屏上。所以,菊池带可被视为衍射面的投影,菊池带的交点即为晶带轴的投影。相对于入射束方向,衍射方向是背散射的方向,所以被称作电子背散射衍射。
EBSD技术通常借助于商用软件对菊池花样进行自动标定。为了方便计算机识别和处理,仪器采集到的菊池花样需要进行Hough变换[3]。Hough变换可以使软件更准确和方便地识别出菊池带,并算出菊池带的夹角和相对位置[5]。识别出的菊池带与已知结构的数据进行比对,可以判别物相的结构和取向[11]。为了更好地表示各个区域之间的取向、物相等关系,科研人员通常会使用取向图。取向图建立了二维图像上位置与结构/取向的关系,通过软件对取向图的处理可得到样品的结构、取向、晶界、晶粒和应变分布等信息,也可以导出花样质量图、相分布图、晶界分布图等有价值的定量分析数据。
1.2 探测器图 1展示了电镜中大部分EBSD探测器的位置。探测器一般是可伸缩装置,不工作时缩回,工作时探测器伸出并抵近样品,如图 1(a)所示。探测器主要由磷屏和CCD相机(近年出现CMOS相机)构成。其中磷屏将衍射电子转变成光子,光信号通过透镜或者光纤传递给相机,相机再把光信号转成电信号,后续的图像和数据分析系统分析采集到的菊池花样,见图 1(b)所示。最新的直接电子探测相机(Direct Electron Detectors, DED)无磷屏等部件,如图 1(c)所示,可以直接探测电子并将其转换成电信号,详见后文所述。
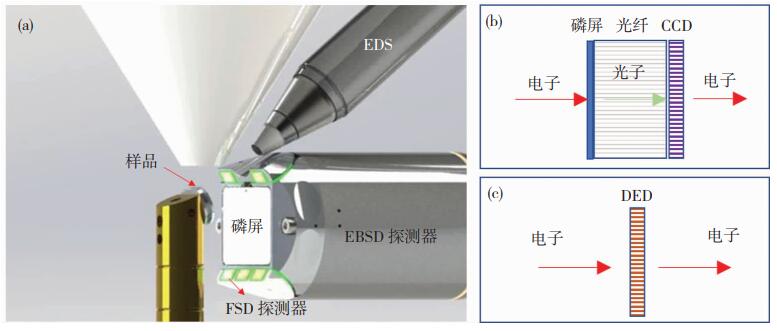
|
图 1 EBSD探测器的位置(a)和信号转换传统方式(b), 直接电子探测方式(c) Fig.1 EBSD detection position (a), traditional signal conversionmethod (b), and direct electron detection method (c) |
菊池花样的主要信息来自于准弹性散射电子,而其他背散射电子则构成了花样的背景。所以,EBSD对于对样品位置、加速电压、束流等测试条件都提出了较高的要求。
对于块状样品,必须大角度倾斜样品,以保证从表层区域产生大量可以满足布拉格条件的准弹性背散射电子。若倾斜角度较小,这部分准弹性背散射电子较少,菊池带的衬度和花样质量也会随之变差。但是大角度倾斜也会带来聚焦和成像上的困难,以及分辨率的下降和不对称,所以通常选取的倾斜角在60°~70°之间,且以70°最为常用。
为了得到更好的花样质量,通常设置高加速电压以提高探测器磷屏的发光效率[2, 12]。由于衍射电子能量更高、穿透力更强,高加速电压还可以减少表面氧化层或者污染物的影响。但是对于块状样品,高加速电压也意味着信号产生区更大、信号范围更广,从而造成分辨率降低和样品漂移、损伤、荷电等不利影响。综合以上各种因素,加速电压通常选择10~30 keV,较常使用20 keV。
形成菊池花样的准弹性背散射电子只占背散射电子的很小一部分。为了提高花样质量,必须增加总体背散射电子的产量。通常设置较高的束流(在场发射电镜中一般为纳安级[13])。通过增加束流可以提高花样质量,减少曝光时间,也使得采集取向图的时间显著减少。但是, 束流增加会伴随束斑的增加,对样品的损伤和表面污染也会加剧。曝光时间和采集时间也同样受限于样品,若扫描时间太长,样品漂移、损伤和污染都会变得明显并影响取向图的质量。因此,使用CCD相机的探测器经常会用到像素合并(Binning),即将多个像素作为一个像素进行处理,以提高处理速度。
总之,EBSD对测试条件和探测器都提出了严格的要求。随着EBSD应用领域的拓展和表征技术的发展,一方面需要探测器适用更宽泛的测试条件,如低加速电压、低束流等;另一方面,在同样的测试条件下,需要探测器获得的菊池花样更清晰,从而提高背散射电子衍射分析的分辨率、速度和效率。
2 提高空间分辨率的措施 2.1 空间分辨率EBSD的空间分辨率可细分为物理分辨率和有效分辨率[14-15]。物理分辨率是分辨大角度晶界两侧不同菊池花样的最小距离;有效分辨率指通过算法,比如图像去卷积,可以分辨相邻取向的最小距离。有效分辨率基于物理分辨率并可能优于后者。提高花样质量有时可以提高有效分辨率。以下主要讨论物理分辨率。
EBSD物理分辨率取决于信号产生区的大小,而信号产生区是材料性质(如原子序数和密度)及实验参数(如样品厚度、倾斜角度和加速电压)的函数[16]。在块体材料中,同实验条件下重元素样品的信号产生区小,且其背散射电子产额高、能量分布窄[13],所以花样质量和分辨率优于轻元素样品[17]。
对块体的EBSD测试,通常需要大角度倾斜样品,如图 2(a)所示。在平行于倾斜轴方向和垂直于倾斜轴方向上,信号的产生区会存在不对称,并且前者的分辨率优于后者(δx小于δy)。这种分辨率数值的差别在倾角在70°时约为3倍,在80°时接近6倍[13]。显然从分辨率角度考量,降低倾角是有利的,但是降低倾角会导致信号量变差,花样质量降低。
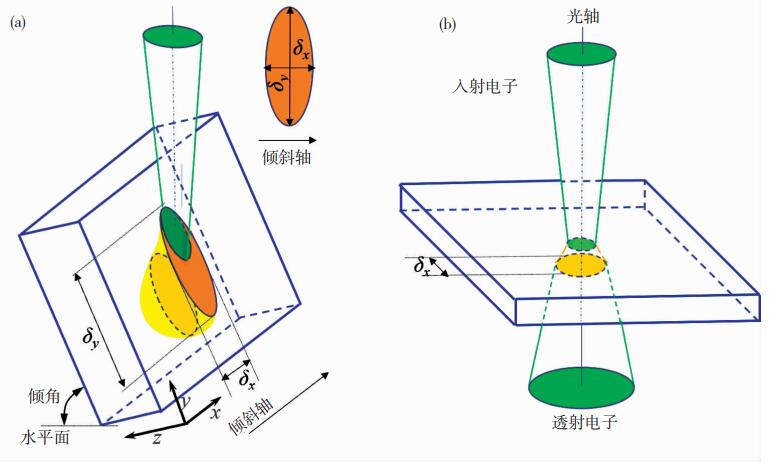
|
图 2 信号产生区和空间分辨率:(a)倾斜块状样品;(b)薄样品 Fig.2 Relationship between information volume and spatial resolution: (a) tilted block sample; (b)thin sample |
目前,对于致密块体材料(如Pt),EBSD的物理分辨率(在平行于倾斜轴方向上)[15]可以达到20 nm,对于过渡族金属(如Cu)可以达到50 nm,对于轻金属(如Al)可以达到200 nm。在垂直于倾斜轴方向上的分辨率更低。
表征纳米晶、变形严重的晶粒等样品,需要更高的分辨率,提高EBSD的空间分辨率的意义不言而喻。为减少信号产生区,可以使用能量过滤、低加速电压和减薄样品等措施。
菊池衍射来自于较高能量的准弹性背散射电子,其他较低能量的背散射电子产生区较大且带来了背底信息。如果过滤掉这些能量较低的背散射电子,除了提高菊池带衬度外,还可以缩小信号产生区,进而提高分辨率。但是信号产生区的缩小并不显著,同时必然牺牲花样的信噪比,增加设备复杂程度[18]。
受制于磷屏探测能力和信号强度,通常设置较高的加速电压,如20 keV。使用较低加速电压时,如7 keV,信号产生区会明显减小,并且潜在的分辨率也会提高。总体上看,空间分辨率随着加速电压的减少和原子序数的增加而提高。对于低原子序数材料,降低加速电压可以显著提高空间分辨率,对于高原子序数材料分辨率改善则并不明显[17]。并且,低加速电压时为了补偿花样质量的降低,需要增加束流和束斑,或增加曝光时间和采集时间,反而会加重样品表面的污染和样品漂移。同时低加速电压产生的区域更趋于表面,对表面的应力层和清洁提出了更高的要求。受限于以上原因,使用低加速电压提高分辨率也碰到了许多困难。有关低加速电压的尝试,可以参阅文献[14, 19-22]。
如图 2(b)所示,如果使用薄样品,可以显著减少信号产生区并随之提高分辨率,还可以避免倾斜样品带来分辨率不一致的情况。因此,在EBSD基础上,发展了使用薄样品的透射菊池衍射(TKD)技术[15, 23]。TKD技术发展迅速,应用也在逐渐增多。
3 TKD技术 3.1 TKD技术的优势和设置TKD技术也被称为t-EBSD(Transmission Electron Backscatter Diffraction),适用电子束透明的样品(薄样品)。无需大角度倾斜,透过薄样品的透射电子也可以形成菊池花样,这种设置不仅使得信号产生区大为减小,还使得分辨率不对称情况得到改善,最终提高了分辨率。同时,在同样加速电压下,薄样品中参与形成菊池花样的电子比厚样品的电子能量高、能量分布范围更窄[24]。因此,理论上TKD菊池带的衬度更好[24]。
图 3为28 keV加速电压下,Ni薄膜(50 nm,20°倾斜,依TKD的通常设置)和Ni块体(70°倾斜,依EBSD的通常设置)样品分别使用蒙特卡洛模拟软件(CASINOv2.4.2)进行模拟。由图 3(a)可以看出,透射电子能量更高、分布更窄。图 3(b)信号电子终端能量取自图 3(a)信号电子的峰值(27 keV),由图可见TKD的信号产生区更小。

|
图 3 EBSD和TKD信号电子能量谱图和产生区:(a)信号电子能量谱;(b)信号产生区 Fig.3 Energy spectrum and information volume of EBSD and TKD: (a) energy spectrum of signal electron; (b) information volume area |
图 4为多晶硅薄膜的取向图,薄膜厚度约为100 nm。当加速电压为7 keV时,形成菊池花样的背散射电子来自于样品表面,此时样品可以视为块体材料;当加速电压设置为20 keV时,采集透射电子得到菊池花样,样品可以视为薄样品。图 4(a)采取降低加速电压的方式,但是取向图的信噪比和空间分辨率都较差。相反,图 4(b)则是使用TKD技术得到的取向图,细节清晰,信噪比和细腻度也明显优于图 4(a)。

|
图 4 多晶硅的取向图[25]:(a)普通EBSD,块体材料,加速电压7 keV;(b)TKD,薄膜材料,加速电压30 keV Fig.4 OIM images of polysilicon[25]: (a) EBSD, bulk material, acceleration voltage: 7 keV; (b) TKD, thin film, acceleration voltage: 30 keV |
总之,较之普通EBSD技术,TKD在理论上可以显著提高空间分辨率,使之可以优于10 nm[15]。根据样品情况,目前文献报道最高的有效分辨率可以达到2 nm[26]。
3.2 同轴TKD技术在TKD技术中,依据探测器是否处在光轴上,又分成了离轴的TKD技术和新近出现的同轴TKD技术[6],本文着重介绍同轴TKD技术。
离轴TKD探测器跟普通EBSD设置一样,不在电子束光轴上,如图 5所示。为了接受更大角度范围的衍射电子束,需要略微倾斜样品,倾角常设为20°。离轴TKD的这种布置只能接收部分散射束而错过了大部分的散射束,这就决定了菊池花样对束流的依赖。并且菊池花样中条带有限且菊池带上窄下宽[8],如图 5中离轴探测器对应的菊池花样。

|
图 5 离轴和同轴TKD的设置和对应花样 Fig.5 Off-axis and on-axis TKD settings and corresponding patterns |
2016年以来出现了同轴TKD技术[6]。这种方法使探测器磷屏垂直于光轴并布置在样品正下方,可以接收靠近光轴方向的低角度散射束,如图 5所示。因为低角度散射束比高角度散射束强度更高[6-7, 27-28],这种设置可以降低对束流的要求,同时菊池花样不会出现明显畸变,如图 5中同轴探测器对应的菊池花样所示。但是该设置也存在需要解决的困难:较强的透射束会在花样中形成过曝的亮斑;散射束中也可能出现透射电镜中可见的衍射斑、菊池线对和高阶劳厄衍射[29]等信息。比如图 5同轴花样中的亮点即为衍射斑。虽然过曝斑减少了花样面积,但可以调节加速电压和束流进行控制。实践证明,这些过曝斑和衍射斑不妨碍商用程序对正常条带的识别[8, 30]。
表征超细晶粒、超高位错密度材料的结构和取向,需要更高的空间分辨率。普通EBSD难以满足要求,需要使用TKD技术[6, 8, 15]。在这些应用中,高空间分辨率需要较小的束斑,降低束斑必然降低束流,也必然对菊池花样质量和曝光时间进行折衷,此时离轴TKD会受到以下限制:若增加像素合并和缩小曝光时间,会降低花样质量;若曝光时间较长,则增加了取向图的采集时间,并造成明显的样品漂移[8]。相对于离轴TKD,同轴TKD没有显著提高空间分辨率,但是可以降低对束流的要求。接收强度高的低角度散射束使它在同等厚度和花样质量下可以采用稍小的束斑电流,或者同样束流下更快的采集速度。有研究表明[7],达到同样花样质量和标定率,在同样束流下同轴TKD比离轴TKD采集速度缩短20倍,在同样时间下束流可以降低20倍。并且,同轴TKD的位置类似扫描电镜中的STEM探测器,位于样品正下方。TKD本身的FSD探测器还可以实现STEM的明场像和暗场像功能[8, 9, 31]。
4 探测器技术进展为了降低对设置参数(加速电压、束流、像素合并和曝光时间)的要求,并适应更多类型的样品,同时能够提高花样质量,以及从花样中获得更多细节,在探测器方面也出现了很多技术进展[32-37]。
4.1 CMOS相机目前已安装的EBSD探测器大多仍采用电荷藕合器件(Charge Couple Device,CCD)相机[13, 33, 36-38],它使用CCD芯片。CCD芯片不能直接探测电子[39],而是通过磷屏中的闪烁体将电子转换成光子,随后经光纤或透镜将光子传输至CCD传感器继而转换成电信号,如图 1(b)所示。这样电子-光子-电子的处理方式会必然出现磷屏、光纤或透镜中的光散射和能量吸收,这些都会降低花样的信噪比和空间分辨率[33, 36-37]。另外CCD芯片串行处理信号,耗时相对较长。为了提高处理速度,CCD相机通常需进行像素合并。过度的像素合并会明显地牺牲花样质量。
互补金属氧化物半导体(Complementary Metal Oxide Semiconductor,CMOS)芯片发展迅速。目前,部分新型探测器仍然使用磷屏,但是用CMOS相机替换CCD相机。CMOS相机利用CMOS芯片处理速度更快的优点,降低对像素合并的要求,从而达到更快的花样采集速度[32]。
4.2 直接电子探测相机直接探测电子相机(以下简称DED)因其分辨率高在透射电镜和透射扫描电镜得到越来越多的应用[38],使用也越发广泛。它使用结构更为复杂、耐辐照的CMOS芯片来直接探测电子。使用DED用于记录衍射花样、成像和动态观察,具有更高量子效率、更高空间分辨率、更快读取速度和耐辐照的优点[33, 37-41]。
同样用于记录衍射花样,在EBSD领域也开始使用DED相机[33, 35-37]。相对于其他相机,它具有独特的优点。首先,扫描电镜相对较低的加速电压(最高加速电压为30 kV)基本上不用考虑电子束损伤[33];其次,如图 1(c)所示,它没有磷屏以及光纤或透镜。这样就没有光散射、能量吸收和光学透镜的像差,必然提高了探测信号的效率。
因此,DED相机在提高花样信噪比的同时,低束流或者低加速电压下的花样质量也得到了提高,从而提高了EBSD的空间分辨率[33, 36-37]。另外,DED具有能量过滤的功能,能够提高菊池带衬度并从菊池花样中获得更多细节信息[33, 36-37],并增加菊池带测量的准确性。文献[42-43]使用DED相机采集菊池花样,结合深度学习直接从高精度花样中提取信息。这种技术可以发掘衍射花样中的更多细微特征,进而更精确地识别物相以及晶体结构,解决了Hough变换方法难以对相似结构进行判别的难题。
5 结论与展望结合EBSD,扫描电镜可以获得以往只有透射电镜同时具备的电子衍射和成像功能,EBSD探测器为扫描电镜带来了强大的结构和取向分析功能,更全面地反映样品的微观特征。
随着电子背散射衍射的技术进展,能量过滤和采用低加速电压可以提高空间分辨率,但是受到较多限制,而使用薄样品的TKD技术大大拓展了技术的适用范围。CMOS和直接电子探测相机等新技术可以对花样进行更快地处理、更清晰地呈现。这些在表征技术上的进展,使得电子背散射衍射具有更高的分辨率、更快的速度和更高的效率,在材料科学与工艺中的应用会继续大放异彩。
随着离子研磨等制样技术的普及,以及硬件技术和算法的蓬勃发展,EBSD在晶体材料领域应用的深度和广度都在迅速增加。未来,EBSD不仅会实现更高空间分辨率,还可以实现更快的采集速度,这些都将促进对晶体材料的研究水平和提高解决问题的能力。
| [1] |
曾毅, 吴伟, 刘紫微. 低加速电压扫描电镜应用技术研究[M]. 上海: 上海科学技术出版社, 2015. ZENG Y, WU Wei, LIU Ziwei. Research on application technology of low accelerating voltage scanning electron microscope[M]. Shanghai: Shanghai Science and Technology Press, 2015. |
| [2] |
杨平. 电子背散射衍射技术及其应用[M]. 北京: 冶金工业出版社, 2007. YANG Ping. Electron backscatter diffraction technique and its application[M]. Peking: Metallurgical Industry Press, 2007. |
| [3] |
RANDLE V. Recent developments in electron backscatter diffraction[J]. Advances in Imaging and Electron Physics, 2008, 151(7): 363-416. DOI:10.1016/S1076-5670(07)00405-3 |
| [4] |
RANDLE V. Applications of electron backscatter diffraction to materials science: status in 2009[J]. Journal of Materials Science, 2009, 44(16): 4211-4218. DOI:10.1007/s10853-009-3570-0 |
| [5] |
ZAEFFERER S. A critical review of orientation microscopy in SEM and TEM[J]. Crystal Research & Technology, 2011, 46(6): 607-628. DOI:10.1002/crat.201100125 |
| [6] |
FUNDENBERGER J J, BOUZY E, GORAN D, et al. Orientation mapping by transmission-SEM with an on-axis detector[J]. Ultramicroscopy, 2016, 161: 17-22. DOI:10.1016/j.ultramic.2015.11.002 |
| [7] |
YUAN H, BRODU E, CHEN C, et al. On-axis versus off-axis Transmission Kikuchi diffraction technique: application to the characterisation of severe plastic deformationinduced ultrafine-grained microstructures[J]. Journal of Microscopy, 2017, 267(1): 70-80. DOI:10.1111/jmi.12548 |
| [8] |
NIESSEN F, BURROWS A, FANTA A. A systematic comparison of on-axis and off-axis transmission Kikuchi diffraction[J]. Ultramicroscopy, 2018, 186: 158-170. DOI:10.1016/j.ultramic.2017.12.017 |
| [9] |
FANTA A B, FULLER A, ALIMADADI H, et al. Improving the imaging capability of an on-axis Transmission Kikuchi Detector[J]. Ultramicroscopy, 2019, 206: 112812D. DOI:10.1016/j.ultramic.2019.112812 |
| [10] |
ZAEFFERER S. On the formation mechanisms, spatial resolution and intensity of backscatter Kikuchi patterns[J]. Ultramicroscopy, 2007, 107(2): 254-266. DOI:10.1016/j.ultramic.2006.08.007 |
| [11] |
WILKINSON A J, BRITTON T B. Strains, planes, and EBSD in materials science[J]. Materials Today, 2012, 15(9): 366-376. DOI:10.1016/S1369-7021(12)70163-3 |
| [12] |
BABA-KISHI K Z. Review Electron backscatter Kikuchi diffraction in the scanning electron microscope for crystallographic analysis[J]. Journal of Materials Science, 2002, 37(9): 1715-1746. DOI:10.1023/A:1014964916670 |
| [13] |
GOLDSTEIN J, NEWBURY D E, et al. Scanning electron microscopy and X-Ray microanalysis[M]. 4th. Springer, 2018.
|
| [14] |
STEINMETZ D R, ZAEFFERER S. Towards ultrahigh resolution EBSD by low accelerating voltage[J]. Materials Science and Technology, 2010, 26(6): 640-645. DOI:10.1179/026708309X12506933873828 |
| [15] |
BORRAJO-PELAEZ R, HEDSTRÖM P. Recent developments of crystallographic analysis methods in the scanning electron microscope for applications in metallurgy[J]. Critical Reviews in Solid State & Material Sciences, 2017, 43(2): 1-20. DOI:10.1080/10408436.2017.1370576 |
| [16] |
REN S X, KENIK E A, ALEXANDER K B, et al. Exploring spatial resolution in electron back-scattered diffraction experiments via montecarlo simulation[J]. Microscopy and Microanalysis, 1998, 4(1): 15-22. DOI:10.1017/S1431927698980011 |
| [17] |
CHEN D, KUO J. The effect of atomic mass on the physical spatial resolution in EBSD[J]. Microscopy and Microanalysis, 2013, 19(S5): 4-7. DOI:10.1017/S143192761301221X |
| [18] |
SCHWARTZ A J, KUMAR M, ADAMS B L, et al. Electron backscatter diffraction in materials science[M]. 2nd. Springer, 2009.
|
| [19] |
DORRI M, TURGEON S, BRODUSCH N, et al. Characterization of amorphous oxide nano-thick layers on 316L stainless steel by electron channeling contrast imaging and electron backscatter diffraction[J]. Microscopy and Microanalysis, 2016, 22(5): 997-1006. DOI:10.1017/S1431927616011612 |
| [20] |
SINGH S, GUO Y, WINIARSKI B, et al. High resolution low kV EBSD of heavily deformed and nanocrystallinealuminium by dictionary-based indexing[J]. Scientific Reports, 2018, 8(1): 1-8. DOI:10.1038/s41598-018-29315-8 |
| [21] |
ABBASI K, WANG D, FUSELLA M A, et al. Methods for conducting electron backscattered diffraction (EBSD) on polycrystalline organic molecular thin films[J]. Microscopy and Microanalysis, 2018, 24(4): 420-423. DOI:10.1017/S1431927618000442 |
| [22] |
GRIESSHABER E, UBHI H S, SCHMAHL W W. Nanometer scale microstructure and microtexture of biological materials revealed by high spatial resolution (15 to 5 kV) EBSD[J]. Materials Science Forum, 2012, 702-703: 924-927. DOI:10.4028/www.scientific.net/MSF.702-703.924 |
| [23] |
SNEDDON G C, TRIMBY P W, CAIRNEY J M. Transmission kikuchi diffraction in a scanning electron microscope: areview[J]. Materials Science & Engineering R, 2016, 110: 1-12. DOI:10.1016/j.mser.2016.10.001 |
| [24] |
KELLER R R, GEISS R H. Transmission EBSD from 10 nm domains in a scanning electron microscope[J]. Journal of Microscopy, 2012, 245(3): 245-251. DOI:10.1111/j.1365-2818.2011.03566.x |
| [25] |
Transmission kikuchi diffraction in the scanning electron microscope[EB/OL]. https://www.bruker.com/events/webinars/transmission-kikuchi-diffraction-in-the-scanning-electron-microscope.html
|
| [26] |
TRIMBY P W. Orientation mapping of nanostructured materials using transmission kikuchi diffraction in the scanning electron microscope[J]. Ultramicroscopy, 2012, 120(5): 16-24. DOI:10.1016/j.ultramic.2012.06.004 |
| [27] |
BRODUSCH N, DEMERS H, GAUVIN R, et al. Nanometres-resolution kikuchi patterns from materials science specimens with transmission electron forward scatter diffraction in the scanning electron microscope[J]. Journal of Microscopy, 2013, 250(1): 1-14. DOI:10.1111/jmi.12007 |
| [28] |
VAN BREMEN R, GOMES D R, DE JEER L T, et al. On the optimum resolution of transmission-electron backscattered diffraction (t-EBSD)[J]. Ultramicroscopy, 2016, 160: 256-264. DOI:10.1016/j.ultramic.2015.10.025 |
| [29] |
BRODU E, BOUZY E, FUNDENBERGER J, et al. Diffraction contrast dependence on sample thickness and I ncident energy in on-axis transmission Kikuchi diffraction in SEM[J]. Ultramicroscopy, 2017, 181: 123-133. DOI:10.1016/j.ultramic.2017.04.017 |
| [30] |
BURTON G L, WRIGHT S, STOKES A, et al. Orientation mapping with kikuchi patterns generated from a focused STEM probe and indexing with commercially available EDAX software[J]. Ultramicroscopy, 2020, 209: 112882. DOI:10.1016/j.ultramic.2019.112882 |
| [31] |
LIU J, LOZANOPEREZ S, KARAMCHED P, et al. Forescattered electron imaging of nanoparticles in scanning electron microscopy[J]. Materials Characterization, 2019, 115(9): 109814. DOI:10.1016/j.matchar.2019.109814 |
| [32] |
GOULDEN J, TRIMBY P, BEWICK A, et al. The benefits and applications of a CMOS-based EBSD detector[J]. Microscopy and Microanalysis, 2018, 24(S1): 1128-1129. DOI:10.1017/S1431927618006128 |
| [33] |
VESPUCCI S, WINKELMANN A, NARESHKUMAR G, et al. Digital direct electron imaging of energy-filtered electron backscatter diffraction patterns[J]. Physical Review B, 2015, 92(20): 205301. DOI:10.1103/PhysRevB.92.205301 |
| [34] |
MATHESON J, MOLDOVAN G, KIRKLAND A, et al. Testing and comparison of imaging detectors for electrons in the energy range 10-20 keV[J]. Journal of Instrumentation, 2017, 12(11): C11016. DOI:10.1088/1748-0221/12/11/c11016 |
| [35] |
MINGARD K P, STEWART M, GEE M G, et al. Practical application of direct electron detectors to EBSD mapping in 2D and 3D[J]. Ultramicroscopy, 2017, 184: 242-251. DOI:10.1016/j.ultramic.2017.09.008 |
| [36] |
WILKINSON A J, MOLDOVAN G, BRITTON T B, et al. Direct detection of electron backscatter diffraction patterns[J]. Physical Review Letters, 2013, 111(6): 065506. DOI:10.1103/PhysRevLett.111.065506 |
| [37] |
VESPUCCI S, WINKELMANN A, MINGARD K, et al. Exploring transmission kikuchi diffraction using a timepix detector[J]. Journal of Instrumentation, 2017, 12(2): C020075. DOI:10.1088/1748-0221/12/02/C02075 |
| [38] |
FARUQI A R, MCMULLAN G. Direct imaging detectors for electron microscopy[J]. Nuclear Instruments & Methods in Physics Research, 2018, 878(11): 180-190. DOI:10.1016/j.nima.2017.07.037 |
| [39] |
BELL D C, ERDMAN N. What's next? the future directions in low voltage electron microscopy[M]. John Wie & Sons, Lte, 2012: 185-200.
|
| [40] |
CARTER C B, WILLIAMS D B. Transmission electron microscopy; diffraction, imaging, and spectrometry[M]. Switzerland: Springer, 2016.
|
| [41] |
ZUO J M, SPENCE J C H. Advanced transmission electron microscopy[M]. NewYork: Springer Science, 2017.
|
| [42] |
KAUFMANN K, ZHU C, ROSENGARTEN A S, et al. Phase mapping in EBSD using convolutional neural networks[J]. Microscopy and Microanalysis, 2020, 26(3): 458-468. DOI:10.1017/S1431927620001488 |
| [43] |
KAUFMANN K, ZHU C, ROSENGARTEN A S, et al. Deep neural network enabled space group identification in EBSD[J]. Microscopy and Microanalysis, 2020, 26(3): 447-457. DOI:10.1017/S1431927620001506 |
 2021, Vol. 29
2021, Vol. 29


