2. 清华大学 材料学院,北京 100084
2. School of Materials Science and Engineering, Tsinghua University, Beijing 100084, China
当前,基于硅材料的闪存(Flash memory)由于具有非易失性、高密度和低功耗等优点而占据了二级存储器的主流市场.但是,由于漏电流效应会随着器件尺寸的减小而急剧增大,基于电荷捕获机理工作的Flash存储器即将达到其小型化极限.为了突破Flash存储器所面临的小型化极限,同时也为了追求更快的擦写速度和更低的操作功耗,近年4种新型非易失性存储概念受到科学界和工业界的广泛关注,包括基于铁电极化可逆翻转效应的铁电随机存储器(Ferroelectric Random Access Memory,FRAM)[1]、基于磁阻效应的磁阻随机存储器(Magnetoresistive RAM,MRAM)[2]、基于晶态/非晶态可逆转变效应的相变随机存储器(Phase-change RAM,PRAM)[3]和基于电致电阻转变效应的阻变随机存储器(Resistive RAM,RRAM)[4-7].整体上,RRAM除了兼具高速、高密度和低功耗的3大核心性能外,还具有结构简单、易于集成、材料来源广泛等优点,被认为是最有希望的下一代非易失性存储器之一.
根据阻变机理,RRAM可以被粗略地分为离子迁移型、热化学反应型和电子捕获/释放型3类,其中离子迁移型又可分为阳离子迁移型和阴离子迁移型两类[7].在这几类之中,阳离子迁移型RRAM可兼具高开关比、低功耗以及优异的循环耐受性和数据保持特性等优点,因而具有较明朗的商业化前景,也因此受到科学界和工业界的较多关注.实际应用中,阳离子迁移型RRAM采用十字交叉阵列结构进行集成,每一个交叉点都是一个存储单元,由活性电极(Active Electrode,AE)/存储介质/惰性电极(Inert Electrode,IE)的3层膜构成,如图 1的左上内插图所示.当IE接地,外电压施加在AE上时,阳离子迁移型RRAM表现出典型的双极性阻变(Bipolar Resistive Switching,BRS)行为,其电流-电压(Current-Voltage,I-V)特性如图 1所示,微观机理如图 1的右下内插图所示.正电压使得器件从高电阻态(High Resistance State,HRS)转变到低电阻态(Low Resistance State,LRS),记为“set过程”,对应于金属导电细丝(metal filament)的形成,而负电压使得器件从LRS转变回HRS,记为“reset过程”,对应于金属导电细丝的局部断开.此外,需要指出两点:1) 图 1中的ICC代表限制电流(compliance current),是为了防止器件在set过程中被永久击穿,同时也可通过设置不同的ICC来调控金属导电细丝的尺寸[8-9];2) 金属导电细丝在外加电压下的形成过程中必然伴随有存储介质中阴离子(比如,氧离子)的迁移[10-11],但这一迁移过程在绝大多数阳离子迁移型RRAM中都可以被合理地忽略,正如本文中所讨论的情形.
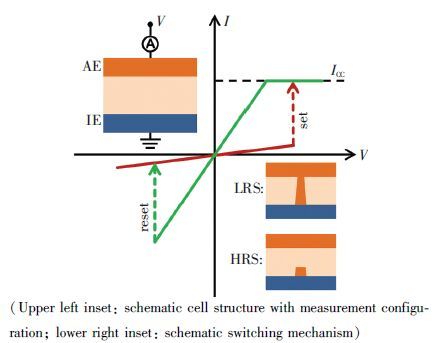
|
图 1 阳离子迁移型RRAM的I-V特性示意图 Figure 1 Schematic I-V characteristic of a cation-migration-based RRAM cell |
本文从材料、阻变机理和器件性能3个方面综述了阳离子迁移型阻变存储器的研究进展,其中材料部分包括电极材料和存储介质,阻变机理部分包括金属导电细丝的存在、生长模式和生长动力学,而器件性能部分包括开关比、擦写速度、擦写功耗、循环耐受性、数据保持特性以及器件小型化潜力.最后,对本领域的未来研究重点进行了展望.
1 材料 1.1 电极材料阳离子迁移型RRAM的电极包括AE和CE两类,二者的共同之处在于均起导电作用,而不同之处在于AE还通过氧化还原反应在存储介质中形成金属导电细丝.相应地,本文将电极材料分为AE材料和CE材料两类进行进展总结和讨论.对于AE材料,最常见的是Cu[12-16]和Ag[17-21],其次是Ni[22-24],剩下的则是偶尔被报道的Al[25]、Ti[26] 、Co[27] 、Nb[28]、Au[29]等.从原理上讲,要想使AE通过氧化还原反应在存储介质中形成金属导电细丝,AE材料应首先容易被电离为阳离子,同时生成的阳离子要难以与存储介质中的阴离子结合.因此,AE材料应首先具有较小的标准电极电势(Eθ)以保证容易被电离,同时其氧化物的标准生成吉布斯自由能(△fGθ)较大以保证生成的阳离子难以与存储介质中的阴离子结合.比较认为,在这些被报道AE材料中,Cu和Ag的Eθ分别为Eθ(Ag+/Ag)=0.799 3 V和Eθ(Cu2+/Cu)=0.339 V,二者的△fGθ分别为△fGθ(Ag2O)=-11.21 和△fGθ(CuO)=-129.7 kJ/mol,因而最能同时满足上述两方面要求,也因此成为最常见的两种AE材料.相比于Ag,Cu更具商业化前景,这是因为Cu已被广泛地用作集成电路的互连材料,因而使得相关器件与现有制备工艺更兼容.对于IE材料,常见的是惰性金属,包括Pt[12-13]、Au[17]、Pd[14]、W[9]等,其他的有ITO[8, 20]、TiN[22]、p/n-Si[30-31]等.此前,IE材料被认为仅仅起导电作用,而对AE材料的氧化还原反应,也就是对金属导电细丝的形成过程,没太多影响.然而,最新研究表明,IE材料对水分子氧化还原反应的催化活性对AE材料的氧化还原反应过程有至关重要的影响[32].这个结论对今后阳离子迁移型RRAM电极选择具有一定的参考价值.此外,n-Si被报道可以与Cu导电细丝形成肖特基接触,进而获得自整流阻变特性,可以在一定程度上克服十字交叉存储阵列的漏电流效应[31].
1.2 存储介质由于阳离子迁移型RRAM的阻变行为起源于金属导电细丝在存储介质中的形成与断开,而金属导电细丝的组分又来源于AE,因而阳离子迁移型RRAM的存储介质主要起提供阳离子迁移通道以形成金属导电细丝的作用.显然,阳离子迁移型RRAM对存储介质的要求比较宽松,这使得其存储介质的来源非常广泛,常见的半导体和绝缘体薄膜几乎都能被用作此类存储介质.已报道的无机存储介质主要包括:氧化物,如AlOx[16]、SiOx[20]、TiOx[33]、ZnOx[18]、ZrOx[34]、MoOx[35]、HfOx[24]、TaOx[12]、WOx[36]等;硫属化合物,如Cu2S[37]、GeSx[9]、Ag2S[38]、GeSex[39-40]等;其他的有AlN[13]、a-C[41]、a-Si[42]等.无机存储介质主要具有CMOS工艺兼容性好、开关比高、循环耐受性强和数据保持特性可靠等优点[12, 39-40],且其制备工艺多样,包括磁控溅射(magnetron sputtering)[18]、原子层沉积(Atomic Layer Deposition,ALD)[16]、脉冲激光沉积(Pulsed Laser Deposition,PLD)[43]、电子束蒸发 (electron beam evaporation)[34]、等离子体氧化(plasma oxidation)[31]等.在众多制备工艺中,磁控溅射和ALD由于能低成本地制得大面积均匀薄膜而最适用于大规模商业化生产.已报道的有机存储介质主要有Alq3[44]、graphene oxide[45]、P3HT∶PCBM[8, 15]、PEDOT∶PSS[19, 46]、PEO[47]、 PMMA[48]、WPF-BT-FEO[49]等.相比于无机存储介质,有机存储介质最突出的优势在于低成本制备和柔性两个方面[47].有机存储介质的制备工艺主要有热蒸发(thermal evaporation)和旋涂(spin coating)两种,其中前者适用于有机小分子,如Alq3[44],而后者则适用于各种聚合物,如P3HT∶PCBM[8, 15]和PEDOT∶PSS[19, 46].
2 阻变机理 2.1 金属导电细丝的存在尽管金属导电细丝的形成与断开已经被公认是阳离子迁移型RRAM的工作机理,但如何能既简单又确凿地证实这样一个机理,即证实金属导电细丝的存在,始终是科学界关注的热点之一.证实金属导电细丝存在的方法可分为直接法和间接法两类,下面对其分别进行进展总结和讨论.
直接法,顾名思义,是指采用各种分析表征手段直接看到金属导电细丝的方法,主要包括光学显微镜(Optical Microscope,OM)[17]、扫描电子显微镜(Scanning Electron Microscope,SEM)[19, 33, 42]、透射电子显微镜(Transmission Electron Microscope,TEM)[18, 34, 46, 49]和飞行时间二次离子质谱仪(Time-of-flight Secondary Ion Mass Spectrometry,ToF-SIMS)[44].比较来看,OM和SEM属于无损探测,但仅适用于用作机理研究的、大尺寸(AE和IE的间距通常不小于200 nm)的平面型器件,如HSIUNG等[33]利用SEM在Ag/TiO2/Pt平面型器件处于LRS时清晰地看到了Ag导电细丝;TEM和ToF-SIMS则属于有损探测,但更适用于接近实际应用的、纳米尺度(主要指AE和IE的间距,即存储介质的厚度)的垂直型器件,如YANG等[18]利用TEM成像并结合能量色散X射线谱(Energy Dispersive X-Ray spectroscopy,EDX)分析证实了Ag/ZnO∶Mn/Pt垂直型器件的Ag导电细丝机理,如图 2所示.需要指出的是,TEM样品的制备成本通常较高,且由于金属导电细丝的纳米尺寸和位置随机性,在不事先定位金属导电细丝的情况下,利用截面TEM样品观察金属导电细丝的成功率非常低的.此外,虽然BUSBY等[44]已成功利用ToF-SIMS三维成像证实了金属导电细丝的存在,但由于其自身的横向分辨率较低(~1 μm),该方法很难给出纳米金属导电细丝的形状等更多信息.
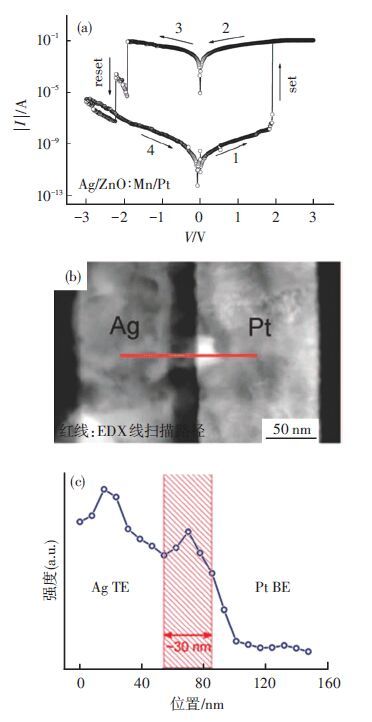
|
图 2 金属导电细丝的直接观察[18] Figure 2 The direct observation of metal filament[18]:(a) Representative I-V characteristic of a vertical Ag/ZnO∶Mn/Pt RRAM cell;(b) TEM image;(c) corresponding EDX line profile of the Ag filament in a vertical Ag/ZnO∶Mn/Pt RRAM cell |
间接法是指通过测量金属导电细丝特有的电学或磁学特性来间接反应其存在的方法.相比于直接法,间接法的最大优势在于,它能简单高效且无损地探测垂直型器件中的金属导电细丝.同时,由于其巧妙地利用了金属导电细丝特有的电学或磁学特性,间接法的可靠性通常不亚于直接法.基于电学特性的间接法包括电阻温度系数(Temperature Coefficient of Resistance,TCR)测试和超导转变温度(superconducting transition temperature,Tc)测试.如,GAO等[15]和SUN等[23]分别利用TCR测试证实了Cu/P3HT:PCBM/ITO垂直型器件的Cu导电细丝机理和Ni/ZrO2/Pt垂直型器件的Ni导电细丝机理,而ZHU等[28]通过测试发现,Nb/ZnO/Pt垂直型器件处于LRS时显示出 Tc=~9.3 K,证实了该器件的Nb导电细丝机理.基于磁学特性的间接法可分为测量需要金属导电细丝参与的磁阻效应和测量金属导电细自身的磁阻效应.对于前者,YANG等[27] 通过测量隧道磁阻(Tunnel Magnetoresistance,TMR)效应证实了Co/ZnO/Fe垂直型器件的Co导电细丝机理,而JANG等[50]通过测量巨磁阻(Giant MR,GMR)效应证实了Co/TaOx/Cu/Py垂直型器件的Cu导电细丝机理.对于后者,OTSUKA等[24, 51]通过测量各向异性磁阻(Anisotropic MR,AMR)效应证实了Ni/HfO2/Pt和Ni/TiO2/Pt垂直型器件的Ni导电细丝机理.需要指出的是,TCR测试的适用范围最广,但其干扰因素较多,使用时需要特别谨慎,而Tc测试和各种磁阻测试的适用范围非常有限,但其具有极高的可靠性.
2.2 金属导电细丝的生长模式证实金属导电细丝的存在只是关于阳离子迁移型RRAM机理研究的第一步,而更深一层的工作则是弄清金属导电细丝的动态形成与断开过程,这不仅具有重大的科学意义,也将对相关器件的结构设计和性能优化提供理论指导.相比于形成过程,金属导电细丝的断开过程则甚为简单,已被科学界公认是由焦耳热辅助的阳极氧化引起的,且断开位置在金属导电细丝的最薄弱之处.因此,此处的关注重点是金属导电细丝的形成过程.至今,已经被直接证明的金属导电细丝生长模式有如下3种.
1) 金属导电细丝首先在IE附件形核.如图 3(a)所示,而后随着时间的推移从IE向AE生长,记为“AE←IE”生长模式.这种生长模式与经典电化学理论完全吻合,也最先被直接证明.
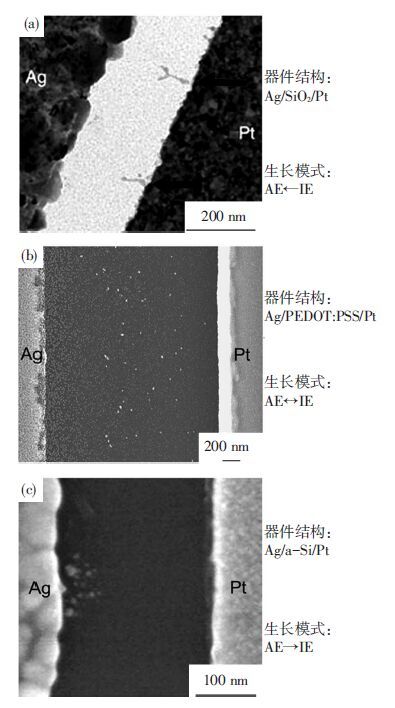
|
图 3 3种金属导电细丝生长模式的代表性器件及其初始形核区域的直接观察[19, 42] Figure 3 Representative devices withnucleation location for three growth modes of metal filaments:(a) nucleation location near the IE [42];(b) nucleation location in almost the whole region between AE and IE[19];(c) nucleation location near the AE[42] |
早在1976年,HIROSE 等[17]就利用OM直接证实,Ag导电细丝在Ag/Ag-As2S3/Au平面型器件中从Au电极向Ag电极生长.在这之后的工作中,这种生长模式也经常被直接观察到,如在Cu/Cu-GeTe/Pt-Ir垂直型器件[52]、Cu/MoOx/TiN垂直型器件[35]以及Ag/SiO2/Pt 平面型器件[42].
2) 金属导电细丝首先在AE和IE之间大范围形核.如图 3(b)所示,而后随着时间的推移,核心增多、长大并逐渐联通,最终发展成为导电细丝,记为“AE↔IE”生长模式.相对来说,这种生长模式的报道较少,其代表性器件为如图 3(b)所示的Ag/PEDOT∶PSS/Pt平面型器件[19].
3) 金属导电细丝首先在AE附件形核.如图 3(c)所示,而后随着时间的推移从AE向IE生长,记为“AE→IE”生长模式.这种生长模式最近被越来越频繁地报道,如在Ag(或Cu)/ZrO2/Pt垂直型器件[53]、Ag/Al2O3/Pt平面型器件[42]、Ag/a-Si/Pt平面型和垂直型器件[42]等.
需要指出的是,上述3种金属导电细丝生长模式并非毫无联系,如第2种生长模式可以看作是第1种和第3种之间的过渡模式.尤其是,YANG等[54]最近利用原位TEM研究了Ag导电细丝在电子束蒸发沉积的SiO2介质中的生长过程,直接观察到了由“AE→IE”生长模式到“AE←IE”生长模式的转变,并将其归因于焦耳热引起的阳离子迁移率和氧化还原速率的同时提升.
2.3 金属导电细丝的生长动力学对于在实验上被直接证明的3种金属导电细丝生长模式,“AE←IE”生长模式可以用经典电化学理论来完美地解释,而“AE↔IE”和“AE→IE”生长模式貌似违背了经典电化学理论,因而一经报道便引起学术界的激烈争论.为了解决这个争论,GAO等[7]最近采用动态蒙特卡洛(Kinetic Monte Carlo,KMC)方法对金属导电细丝的初始形核过程进行了模拟,结果如图 4所示.需要指出的是,能用对金属导电细丝初始形核过程的模拟来代替对其整个生长过程的模拟,是因为这3种生长模式分别对应于不同的初始形核位置,如图 3所示.图 4中深蓝色代表迁移过程主导的“AE→IE”生长模式;黄色代表迁移和形核过程共同作用的“AE↔IE”生长模式;红色代表形核过程主导的“AE←IE”生长模式.此外,为了便于理解,各种生长模式的代表性器件也被定性地标注在图 4中.从图 4可以看出,在固定的形核激活能下,随着迁移激活能的增大,金属导电细丝的生长模式会由“AE←IE”逐渐转变为“AE↔IE”,并最终转变为“AE→IE”;在固定的迁移激活能下,随着形核激活能的增大,金属导电细丝的生长模式会由“AE→IE”逐渐转变为“AE↔IE”,并最终转变为“AE←IE”.对于Ag/a-Si/Pt平面型器件,Ag+离子在a-Si中的迁移率非常低.因此,由Ag电极的电化学溶解而生成的Ag+离子在迁移很小一段距离后就会被还原,形成Ag导电细丝核心.由于这些核心靠近Ag电极,因而它们可以被看作是Ag电极的延伸.随着时间的推移,这些核心将被部分或全部溶解,再次变为Ag+离子.这些新生成的Ag+离子在迁移一小段距离后会再次被还原,形成新的核心.这种周而复始的氧化与还原最终导致Ag导电细丝逐渐从Ag电极向Pt电极生长,即“AE→IE”生长模式.与之相反,对于Ag/SiO2/Pt平面型器件,Ag+离子在SiO2中的迁移率很高.因此,由Ag电极的电化学溶解而生成的Ag+离子可以很迅速地迁移到Pt电极附近,然后被还原,转化为Ag导电细丝核心.随着时间的推移,越来越多的Ag+离子被还原,导致这些核心朝着Ag电极方向逐渐长大,即“AE←IE”生长模式.最后,对于Ag/PEDOT∶PSS/Pt平面型器件,离子迁移率和形核激活能的影响均不能忽略.由Ag电极的电化学溶解而生成的Ag+离子可以迁移一段距离后,在PEDOT∶PSS中的某个地方被还原,形成Ag导电细丝核心.随着时间的推移,这些核心会被部分或全部溶解,也可能逐渐长大.最终,越来越多的核心形成并长大,它们联通后形成导电细丝,即“AE↔IE”生长模式.至此,3种金属导电细丝生长模式均能被从动力学的角度完美解释,极大地推进了我们对阳离子迁移型RRAM工作机理的认识.
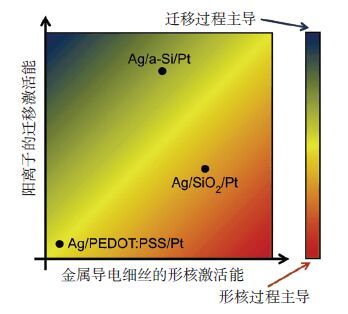
|
图 4 金属导电细丝生长模式与迁移激活能及形核激活能的关系示意图[7] Figure 4 Schematic relationship between the growth mode of metal filaments and the activation energies formigration of cations and nucleation of metal filaments[7] |
在商业化的道路上,阳离子迁移型RRAM的重要考核指标包括开关比(ON/OFF ratio)、擦写速度(write/erase time)、擦写功耗(write/erase energy)、循环耐受性(endurance)、数据保持特性(retention)、器件小型化潜力(miniaturization)等.本文将分别对各种重要考核指标进行进展总结和讨论.需要指出的是,在给定的器件里,各种考核指标之间往往存在着某种制约关系,这将在下一章节进行深入分析和讨论,而此处的进展总结和讨论暂不考虑这些制约关系.
3.1 开关比阳离子迁移型RRAM通常具有较高的开关比,如Ag/ZnO∶Mn/Pt[18]、Cu/HfO2/Pt[55]和Cu/Ta2O5/Pt[12]垂直型器件分别被报道具有>107、>108和>109的超高开关比.高开关比有助于相关器件在实际应用中免于误读操作,同时也为基于单个器件进行多值存储提供了可能性,如AMBROGIO等[9]通过设置不同的ICC来调控Ag导电细丝尺寸在Ag/GeS2/W垂直型器件中获得了5个电阻态,且任意2个相邻态的阻值比都不小于10.
3.2 擦写速度基于Ag/ZnO∶Mn/Pt垂直型器件,YANG等[18]直接证明,阳离子迁移型RRAM具有<5 ns的超快擦写速度,如图 5(a)所示.
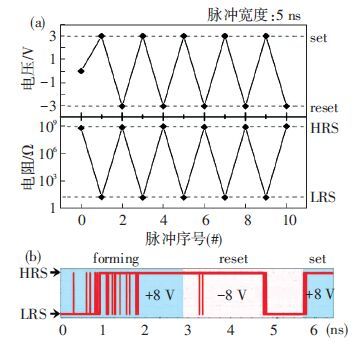
|
图 5 超快擦写速度的测试和模拟结果[18, 56] Figure 5 Experimental and simulated results of ultra-fast write/erase speed:(a) switching characteristic of a vertical Ag/ZnO∶Mn/Pt RRAM cell under 5 ns operation pulses[18];(b) simulated formation and rupture processes of Cu filaments in SiO2 storage medium[56] |
最近,ONOFRIO等[56]利用原子级别的模拟计算证实,Cu导电细丝在SiO2介质中的形成与断开时间均约为1 ns,如图 5(b)所示.此外,利用外推法,GOUX等[57]认为Cu0.6Te0.4/Ti/Al2O3/W垂直型器件可以在<4 V的操作电压下实现<1 ns的超快擦写操作.这些结果表明,阳离子迁移型RRAM的擦写速度远高于Flash存储器(≥1 μs),并可以与主存储器,即动态随机存储器(dynamic RAM,DRAM)相媲美,因而能很好地满足工业界对下一代非易失性存储器在高速擦写方面的要求.
3.3 擦写功耗早在2008年,SCHINDLER等[58]通过测试发现,Cu/SiO2/Ir垂直型器件在10 pA的超低操作电流下仍能具有约10倍的开关比,表明阳离子迁移型RRAM在低功耗方面有巨大潜力.随后,在2013年,GILBERT等[59]报道,Ag/GeS/W垂直型器件可以在1 pJ写入、8 pJ擦除的超低功耗下工作,并通过横向比较得出,阳离子迁移型RRAM比其他一些新型非易失性存储器,比如MRAM 和PRAM,在低功耗方面更有优势.
3.4 循环耐受性已有工作表明,阳离子迁移型RRAM具有远优于Flash存储器(~105次)的循环耐受性,如LV等[55]在Cu/HfO2/Pt垂直型器件实现了高达>109次的连续擦写操作,而KOZICKI等[39]更是在Ag/Ag33Ge22Se47/Ni垂直型器件实现了高达>1011次的连续擦写操作.此外,LV等[55]通过对比测试表明,在保证能成功擦写器件的前提下,减小set脉冲宽度或增大reset脉冲宽度都能较少Cu原子在HfO2介质中的累积,进而可以提高Cu/HfO2/Pt垂直型器件的循环耐受性.这一结论对其他阳离子迁移型RRAM体系的循环耐受性提升具有一定的参考价值.
3.5 数据保持特性利用外推法,阳离子迁移型RRAM已被证明具有在室温甚至是85 ℃保存数据达10年以上时间的能力[40, 60],因而在这一点上能很好地满足工业界的要求.此外,JAMESON等[61]通过掺杂半导体元素把Ag电极非晶化,使得器件能够在200 ℃的高温下成功保存数据达~103 h,因而能够顺利地承受回流焊工艺的高温环境.
3.6 器件小型化潜力在2011年,PARK等[62]首先在Cu/HfO2/Pt垂直型器件中生成Cu导电细丝,然后再将Cu电极刻蚀掉,使得Cu导电细丝裸露在HfO2表面.通过导电原子力显微镜(conductive atomic force microscope,C-AFM)分析得出,Cu导电细丝裸露在HfO2表面的有效直径为2~3 nm.随后,在HfO2上依次沉积TiO2和Pt,形成Cu/TiO2/Pt垂直型器件.在该器件中,Cu电极的有效直径即为2~3 nm.测试结果显示,该器件具有>103的高开关比、<2 μA的低操作电流以及稳定的阻变特性.这一工作表明,阳离子迁移型RRAM具有被小型化到<5 nm的潜力,因而可以轻松突破Flash存储器面临的小型化极限.
4 展望得益于器件制备和表征手段的长足进步,关于阳离子迁移型RRAM的研究工作,特别是在机理和性能方面,在过去10年里取得了巨大进展.但不可否认的是,阳离子迁移型RRAM当前距大规模商业化还有很长一段距离.在未来的研究工作中,应着重关注以下几点.
首先,阐明金属导电细丝的生长动力学对存储介质的微观结构的依赖关系.已有工作表明,同种金属导电细丝在不同制备工艺得到的同一存储介质中可以表现出不同的生长模式.如,Ag导电细丝在溅射制备的SiO2介质中表现出“AE←IE”生长模式[42],而在等离子体增强化学气相沉积和电子束蒸发制备的SiO2介质中则表现出“AE→IE”生长模式[30, 54].显然,不同制备工艺得到的同一存储介质在微观结构上有巨大差异,但这些差异是如何影响离子的迁移和氧化还原过程的仍未可知.若能阐明金属导电细丝的生长动力学对存储介质的微观结构的依赖关系,就能通过优化制备工艺来精确地控制金属导电细丝的生长动力学,进而优化相关器件的性能,推进其商业化进程.
其次,阐明各种存储性能在单个阳离子迁移型RRAM中的相互制约关系.在单个器件中,各种存储性能之间往往存在着制约关系,即一种性能的提升通常是以另一种性能的降低为代价的.如,在HRS阻值不变的前提下,开关比越高意味着LRS阻值越低,而LRS阻值的降低势必会导致擦写功耗的提升.因此,若能全面掌握各种性能之间的制约关系,就能根据实际需求来设定最优的操作模式,以便将器件的性能发挥到极致.
最后,迅速推进阳离子迁移型RRAM在神经形态计算[63-64]、逻辑运算[65-67]等新兴RRAM应用领域的研究工作.这些新兴领域不仅能够极大地拓宽阳离子迁移型RRAM的应用范围,而且蕴藏着更巨大的商业化前景.
| [1] |
MAO D, MEJIA I, SALAS-VILLASENOR A L, et al. Ferroelectric random access memory based on one-transistor-one-capacitor structure for flexible electronics[J]. Organic Electronics, 2013, 14 (2) : 505 –510.
DOI: 10.1016/j.orgel.2012.10.035 ( 0) 0)
|
| [2] |
KHVALKOVSKIY A V, APALKOV D, WATTS S, et al. Basic principles of STT-MRAM cell operation in memory arrays[J]. Journal of Physics D: Applied Physics, 2013, 46 (7) : 074001 .
DOI: 10.1088/0022-3727/46/7/074001 ( 0) 0)
|
| [3] |
付永忠, 程广贵, 王权. 溅射功率和退火温度对GeSbTe相变薄膜内应力的影响[J]. 材料科学与工艺, 2012, 20 (2) : 145 –148.
FU Yongzhong, CHENG Guanggui, WANG Quan. Influence of sputtering power and annealing temperature on internal stress of GeSbTe phase-change films[J]. Materials Science and Technology, 2012, 20 (2) : 145 –148.
( 0) 0)
|
| [4] |
YANG J J, STRUKOV D B, STEWART D R. Memristive devices for computing[J]. Nature Nanotechnology, 2013, 8 (1) : 13 –24.
( 0) 0)
|
| [5] |
PAN F, CHEN C, WANG Z, et al. Nonvolatile resistive switching memories-characteristics, mechanisms and challenges[J]. Progress in Natural Science: Materials International, 2010, 20 : 1 –15.
DOI: 10.1016/S1002-0071(12)60001-X ( 0) 0)
|
| [6] |
CHEN G, SONG C, CHEN C, et al. Resistive switching and magnetic modulation in cobalt-doped ZnO[J]. Advanced Materials, 2012, 24 (26) : 3515 –3520.
DOI: 10.1002/adma.201201595 ( 0) 0)
|
| [7] |
PAN F, GAO S, CHEN C, et al. Recent progress in resistive random access memories: materials, switching mechanisms, and performance[J]. Materials Science and Engineering: R: Reports, 2014, 83 : 1 –59.
DOI: 10.1016/j.mser.2014.06.002 ( 0) 0)
|
| [8] |
GAO S, ZENG F, CHEN C, et al. Conductance quantization in a Ag filament-based polymer resistive memory[J]. Nanotechnology, 2013, 24 (33) : 335201 .
DOI: 10.1088/0957-4484/24/33/335201 ( 0) 0)
|
| [9] |
AMBROGIO S, BALATTI S, CHOI S, et al. Impact of the mechanical stress on switching characteristics of electrochemical resistive memory[J]. Advanced Materials, 2014, 26 (23) : 3885 –3892.
DOI: 10.1002/adma.201306250 ( 0) 0)
|
| [10] |
YANG Y C, CHEN C, ZENG F, et al. Multilevel resistance switching in Cu/TaOx/Pt structures induced by a coupled mechanism[J]. Journal of Applied Physics, 2010, 107 (9) : 093701 .
DOI: 10.1063/1.3399152 ( 0) 0)
|
| [11] |
SHAO X L, ZHAO J S, ZHANG K L, et al. Two-step reset in the resistance switching of the Al/TiOx/Cu structure[J]. ACS Applied Materials & Interfaces, 2013, 5 (21) : 11265 –11270.
( 0) 0)
|
| [12] |
SAKAMOTO T, LISTER K, BANNO N, et al. Electronic transport in Ta2O5 resistive switch[J]. Applied Physics Letters, 2007, 91 (9) : 092110 .
DOI: 10.1063/1.2777170 ( 0) 0)
|
| [13] |
CHEN C, YANG Y C, ZENG F, et al. Bipolar resistive switching in Cu/AlN/Pt nonvolatile memory device[J]. Applied Physics Letters, 2010, 97 (8) : 083502 .
DOI: 10.1063/1.3483158 ( 0) 0)
|
| [14] |
YANG Y, ZHANG X, GAO M, et al. Nonvolatile resistive switching in single crystalline ZnO nanowires[J]. Nanoscale, 2011, 3 (4) : 1917 –1921.
DOI: 10.1039/c1nr10096c ( 0) 0)
|
| [15] |
GAO S, SONG C, CHEN C, et al. Dynamic processes of resistive switching in metallic filament-based organic memory devices[J]. The Journal of Physical Chemistry C, 2012, 116 (33) : 17955 –17959.
DOI: 10.1021/jp305482c ( 0) 0)
|
| [16] |
HUBBARD W, KERELSKY A, JASMIN G, et al. Nanofilament formation and regeneration during Cu/Al2O3 resistive memory switching[J]. Nano Letters, 2015, 15 (6) : 3983 –3987.
DOI: 10.1021/acs.nanolett.5b00901 ( 0) 0)
|
| [17] |
HIROSE Y, HIROSE H. Polarity-dependent memory switching and behavior of Ag dendrite in Ag-photodoped amorphous As2S3 films[J]. Journal of Applied Physics, 1976, 47 (6) : 2767 –2772.
DOI: 10.1063/1.322942 ( 0) 0)
|
| [18] |
YANG Y C, PAN F, LIU Q, et al. Fully room-temperature-fabricated nonvolatile resistive memory for ultrafast and high-density memory application[J]. Nano Letters, 2009, 9 (4) : 1636 –1643.
DOI: 10.1021/nl900006g ( 0) 0)
|
| [19] |
GAO S, SONG C, CHEN C, et al. Formation process of conducting filament in planar organic resistive memory[J]. Applied Physics Letters, 2013, 102 (14) : 141606 .
DOI: 10.1063/1.4802092 ( 0) 0)
|
| [20] |
GAO S, CHEN C, ZHAI Z, et al. Resistive switching and conductance quantization in Ag/SiO2/indium tin oxide resistive memories[J]. Applied Physics Letters, 2014, 105 (6) : 063504 .
DOI: 10.1063/1.4893277 ( 0) 0)
|
| [21] |
TSURUOKA T, VALOV I, TAPPERTZHOFEN S, et al. Redox reactions at Cu, Ag/Ta2O5 interfaces and the effects of Ta2O5 film density on the forming process in atomic switch structures[J]. Advanced Functional Materials, 2015, 25 (40) : 6374 –6381.
DOI: 10.1002/adfm.v25.40 ( 0) 0)
|
| [22] |
CHEN Y Y, POURTOIS G, ADELMANN C, et al. Insights into Ni-filament formation in unipolar-switching Ni/HfO2/TiN resistive random access memory device[J]. Applied Physics Letters, 2012, 100 (11) : 113513 .
DOI: 10.1063/1.3695078 ( 0) 0)
|
| [23] |
SUN J, LIU Q, XIE H, et al. In situ observation of nickel as an oxidizable electrode material for the solid-electrolyte-based resistive random access memory[J]. Applied Physics Letters, 2013, 102 (5) : 053502 .
DOI: 10.1063/1.4790837 ( 0) 0)
|
| [24] |
OTSUKA S, HAMADA Y, ITO D, et al. Magnetoresistance of conductive filament in Ni/HfO2/Pt resistive switching memory[J]. Japanese Journal of Applied Physics, 2015, 54 (5S) : 05ED02 .
DOI: 10.7567/JJAP.54.05ED02 ( 0) 0)
|
| [25] |
PEARSON C, BOWEN L, LEE M W, et al. Focused ion beam and field-emission microscopy of metallic filaments in memory devices based on thin films of an ambipolar organic compound consisting of oxadiazole, carbazole, and fluorene units[J]. Applied Physics Letters, 2013, 102 (21) : 213301 .
DOI: 10.1063/1.4808026 ( 0) 0)
|
| [26] |
PENG P, XIE D, YANG Y, et al. Resistive switching behavior in diamond-like carbon films grown by pulsed laser deposition for resistance switching random access memory application[J]. Journal of Applied Physics, 2012, 111 (8) : 084501 .
DOI: 10.1063/1.3703063 ( 0) 0)
|
| [27] |
YANG Z, ZHAN Q, ZHU X, et al. Tunneling magnetoresistance induced by controllable formation of Co filaments in resistive switching Co/ZnO/Fe structures[J]. EPL (Europhysics Letters), 2014, 108 (5) : 58004 .
DOI: 10.1209/0295-5075/108/58004 ( 0) 0)
|
| [28] |
ZHU X, SU W, LIU Y, et al. Observation of conductance quantization in oxide-based resistive switching memory[J]. Advanced Materials, 2012, 24 (29) : 3941 –3946.
DOI: 10.1002/adma.v24.29 ( 0) 0)
|
| [29] |
BHANSALI U S, KHAN M A, CHA D, et al. Metal-free, single-polymer device exhibits resistive memory effect[J]. ACS Nano, 2013, 7 (12) : 10518 –10524.
DOI: 10.1021/nn403873c ( 0) 0)
|
| [30] |
TIAN X, YANG S, ZENG M, et al. Bipolar electrochemical mechanism for mass transfer in nanoionic resistive memories[J]. Advanced Materials, 2014, 26 (22) : 3649 –3654.
DOI: 10.1002/adma.v26.22 ( 0) 0)
|
| [31] |
TANG G S, ZENG F, CHEN C, et al. Resistive switching with self-rectifying behavior in Cu/SiOx/Si structure fabricated by plasma-oxidation[J]. Journal of Applied Physics, 2013, 113 (24) : 244502 .
DOI: 10.1063/1.4812318 ( 0) 0)
|
| [32] |
TAPPERTZHOFEN S, WASER R, VALOV I. Impact of the counter-electrode material on redox processes in resistive switching memories[J]. Chem Electro Chem, 2014, 1 (8) : 1287 –1292.
( 0) 0)
|
| [33] |
HSIUNG C P, LIAO H W, GAN J Y, et al. Formation and instability of silver nanofilament in Ag-based programmable metallization cells[J]. ACS Nano, 2010, 4 (9) : 5414 –5420.
DOI: 10.1021/nn1010667 ( 0) 0)
|
| [34] |
LIU Q, LONG S, LV H, et al. Controllable growth of nanoscale conductive filaments in solid-electrolyte-based ReRAM by using a metal nanocrystal covered bottom electrode[J]. ACS Nano, 2010, 4 (10) : 6162 –6168.
DOI: 10.1021/nn1017582 ( 0) 0)
|
| [35] |
KUDO M, ARITA M, OHNO Y, et al. Filament formation and erasure in molybdenum oxide during resistive switching cycles[J]. Applied Physics Letters, 2014, 105 (17) : 173504 .
DOI: 10.1063/1.4898773 ( 0) 0)
|
| [36] |
DONGALE T D, MOHITE S V, BAGADE A A, et al. Development of Ag/WO3/ITO thin film memristor using spray pyrolysis method[J]. Electronic Materials Letters, 2015, 11 (6) : 944 –948.
DOI: 10.1007/s13391-015-4180-4 ( 0) 0)
|
| [37] |
SAKAMOTO T, SUNAMURA H, KAWAURA H, et al. Nanometer-scale switches using copper sulfide[J]. Applied Physics Letters, 2003, 82 (18) : 3032 –3034.
DOI: 10.1063/1.1572964 ( 0) 0)
|
| [38] |
XU Z, BANDO Y, WANG W, et al. Real-time in situ HRTEM-resolved resistance switching of Ag2S nanoscale ionic conductor[J]. ACS Nano, 2010, 4 (5) : 2515 –2522.
DOI: 10.1021/nn100483a ( 0) 0)
|
| [39] |
KOZICKI M N, PARK M, MITKOVA M. Nanoscale memory elements based on solid-state electrolytes[J]. IEEE Transactions on Nanotechnology, 2005, 4 (3) : 331 –338.
DOI: 10.1109/TNANO.2005.846936 ( 0) 0)
|
| [40] |
KUND M, BEITEL G, PINNOW C U, et al. Conductive bridging RAM (CBRAM): An emerging non-volatile memory technology scalable to sub 20nm[C]//IEEE International Electron Devices Meeting, 2005. [S.l.]:IEDM Technical Digest,2005.
( 0) 0)
|
| [41] |
ZHUGE F, DAI W, HE C L, et al. Nonvolatile resistive switching memory based on amorphous carbon[J]. Applied Physics Letters, 2010, 96 (16) : 163505 .
DOI: 10.1063/1.3406121 ( 0) 0)
|
| [42] |
YANG Y, GAO P, GABA S, et al. Observation of conducting filament growth in nanoscale resistive memories[J]. Nature Communications, 2012, 3 : 732 .
DOI: 10.1038/ncomms1737 ( 0) 0)
|
| [43] |
HAEMORI M, NAGATA T, CHIKYOW T. Impact of Cu electrode on switching behavior in a Cu/HfO2/Pt structure and resultant Cu ion diffusion[J]. Applied Physics Express, 2009, 2 (6) : 061401 .
( 0) 0)
|
| [44] |
BUSBY Y, NAU S, SAX S, et al. Direct observation of conductive filament formation in Alq3 based organic resistive memories[J]. Journal of Applied Physics, 2015, 118 (7) : 075501 .
DOI: 10.1063/1.4928622 ( 0) 0)
|
| [45] |
HE C L, ZHUGE F, ZHOU X F, et al. Nonvolatile resistive switching in graphene oxide thin films[J]. Applied Physics Letters, 2009, 95 (23) : 232101 .
DOI: 10.1063/1.3271177 ( 0) 0)
|
| [46] |
WANG Z, ZENG F, YANG J, et al. Resistive switching induced by metallic filaments formation through Poly(3, 4-ethylene-dioxythiophene):Poly(styrenesulfonate)[J]. ACS Applied Materials & Interfaces, 2011, 4 (1) : 447 –453.
( 0) 0)
|
| [47] |
MOHAPATRA S R, TSURUOKA T, HASEGAWA T, et al. Flexible resistive switching memory using inkjet printing of a solid polymer electrolyte[J]. AIP Advances, 2012, 2 (2) : 022144 .
DOI: 10.1063/1.4727742 ( 0) 0)
|
| [48] |
MANGALAM J, AGARWAL S, RESMI A N, et al. Resistive switching in polymethyl methacrylate thin films[J]. Organic Electronics, 2016, 29 : 33 –38.
DOI: 10.1016/j.orgel.2015.11.017 ( 0) 0)
|
| [49] |
CHO B, YUN J M, SONG S, et al. Direct observation of Ag filamentary paths in organic resistive memory devices[J]. Advanced Functional Materials, 2011, 21 (20) : 3976 –3981.
DOI: 10.1002/adfm.v21.20 ( 0) 0)
|
| [50] |
JANG H J, KIRILLOV O A, JURCHESCU O D, et al. Spin transport in memristive devices[J]. Applied Physics Letters, 2012, 100 (4) : 043510 .
DOI: 10.1063/1.3679114 ( 0) 0)
|
| [51] |
OTSUKA S, HAMADA Y, SHIMIZU T, et al. Ferromagnetic nano-conductive filament formed in Ni/TiO2/Pt resistive-switching memory[J]. Applied Physics A, 2015, 118 (2) : 613 –619.
DOI: 10.1007/s00339-014-8769-5 ( 0) 0)
|
| [52] |
CHOI S J, PARK G S, KIM K H, et al. In situ observation of voltage-induced multilevel resistive switching in solid electrolyte memory[J]. Advanced Materials, 2011, 23 (29) : 3272 –3277.
DOI: 10.1002/adma.201100507 ( 0) 0)
|
| [53] |
LIU Q, SUN J, LV H, et al. Real-time observation on dynamic growth/dissolution of conductive filaments in oxide-electrolyte-based ReRAM[J]. Advanced Materials, 2012, 24 (14) : 1844 –1849.
DOI: 10.1002/adma.v24.14 ( 0) 0)
|
| [54] |
YANG Y, GAO P, LI L, et al. Electrochemical dynamics of nanoscale metallic inclusions in dielectrics[J]. Nature Communications, 2014, 5 : 4232 .
( 0) 0)
|
| [55] |
LV H, XU X, LIU H, et al. Evolution of conductive filament and its impact on reliability issues in oxide-electrolyte based resistive random access memory[J]. Scientific Reports, 2015, 5 : 7764 .
DOI: 10.1038/srep07764 ( 0) 0)
|
| [56] |
ONOFRIO N, GUZMAN D, STRACHAN A. Atomic origin of ultrafast resistance switching in nanoscale electrometallization cells[J]. Nature Materials, 2015, 14 (4) : 440 –446.
DOI: 10.1038/nmat4221 ( 0) 0)
|
| [57] |
GOUX L, SANKARAN K, KAR G, et al. Field-driven ultrafast sub-ns programming in WAl2O3TiCuTe-based 1T1R CBRAM system[C]//VLSI Technology (VLSIT), 2012 Symposium on. NewYork: IEEE,2012: 69-70.
( 0) 0)
|
| [58] |
SCHINDLER C, WEIDES M, KOZICKI M N, et al. Low current resistive switching in Cu-SiO2 cells[J]. Applied Physics Letters, 2008, 92 (12) : 122910 .
DOI: 10.1063/1.2903707 ( 0) 0)
|
| [59] |
GILBERT N, ZHANG Y, DINH J, et al. A 0.6 V 8 pJ/write non-volatile CBRAM macro embedded in a body sensor node for ultra low energy applications[C]//VLSI Circuits (VLSIC), 2013 Symposium on. NewYork: IEEE, 2013.
( 0) 0)
|
| [60] |
CHEN C, GAO S, TANG G, et al. Cu-embedded AlN-based nonpolar nonvolatile resistive switching memory[J]. IEEE Electron Device Letters, 2012, 33 (12) : 1711 –1713.
DOI: 10.1109/LED.2012.2220953 ( 0) 0)
|
| [61] |
JAMESON J R, BLANCHARD P, CHENG C, et al. Conductive-bridge memory (CBRAM) with excellent high-temperature retention[C]//Electron Devices Meeting (IEDM), 2013 IEEE International. NewYork: IEEE, 2013: 30.1.1 -30.1.4.
( 0) 0)
|
| [62] |
PARK J, LEE W, CHOE M, et al. Quantized conductive filament formed by limited Cu source in sub-5 nm era[C]//Electron Devices Meeting (IEDM), 2011 IEEE International. NewYork: IEEE, 2011: 3.7.1-3.7.4.
( 0) 0)
|
| [63] |
YU S, GAO B, FANG Z, et al. A low energy oxide-based electronic synaptic device for neuromorphic visual systems with tolerance to device variation[J]. Advanced Materials, 2013, 25 (12) : 1774 –1779.
DOI: 10.1002/adma.v25.12 ( 0) 0)
|
| [64] |
LI S, ZENG F, CHEN C, et al. Synaptic plasticity and learning behaviours mimicked through Ag interface movement in an Ag/conducting polymer/Ta memristive system[J]. Journal of Materials Chemistry C, 2013, 1 (34) : 5292 –5298.
DOI: 10.1039/c3tc30575a ( 0) 0)
|
| [65] |
YOU T, SHUAI Y, LUO W, et al. Exploiting memristive BiFeO3 bilayer structures for compact sequential logics[J]. Advanced Functional Materials, 2014, 24 (22) : 3357 –3365.
DOI: 10.1002/adfm.201303365 ( 0) 0)
|
| [66] |
SIEMON A, BREUER T, ASLAM N, et al. Realization of Boolean logic functionality using redox-based memristive devices[J]. Advanced Functional Materials, 2015, 25 (40) : 6414 –6423.
DOI: 10.1002/adfm.v25.40 ( 0) 0)
|
| [67] |
GAO S, ZENG F, WANG M, et al. Implementation of complete Boolean logic functions in single complementary resistive switch[J]. Scientific Reports, 2015, 5 : 15467 .
DOI: 10.1038/srep15467 ( 0) 0)
|
 2016, Vol. 24
2016, Vol. 24


